電子材料の局所表面が化学状態までわかります
ESCA(別名XPS)は一般的に微小部測定を苦手としますが、元素マッピングを併用することで数10μmφまでの局所に対して位置精度の高い表面分析が可能となります。その一例として窒化シリコンに囲まれた直径50μm程度のAlパッド表面について、不純物元素とその化学状態をESCAで評価した事例を紹介します。
ICチップ上のアルミパッド部の分析
主要元素(N,Si,Al)についてマッピングを行い、その分布を確認した後〔図1〕、Alパッド部と周辺部(窒化シリコン)の分析を行いました。定性〔図2〕および元素比率の算出結果〔表1〕から、有機物(C量)はAlパッド部のほうが多く、不純物元素(F)はAlパッド部からのみ検出されることが明らかとなりました。また、CとAlの化学状態を解析した結果〔図3〕、Fは有機物由来ではなく、 Alと結合した無機物由来であることがわかりました。
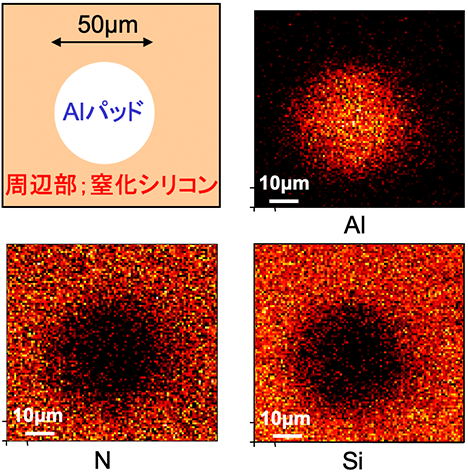
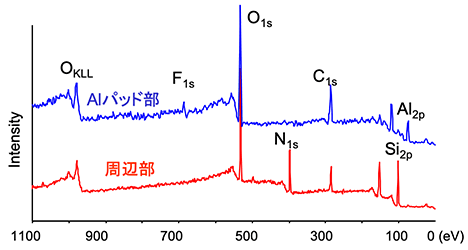

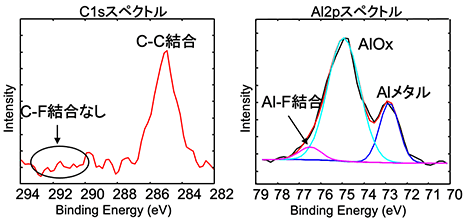
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
