冷却集束イオンビーム/走査型電子顕微鏡複合装置
Cryo Scanning Electronscopy Combined with Focused Ion Beam(Cryo FIB-SEM)

概要
集束イオンビーム(FIB)での微細加工および走査型電子顕微鏡(SEM)による高分解能観察を同時に行える複合装置です。
特徴
- TEM分析用薄膜試料の高精度調製が可能。
- クライオシステムにより、ソフトマテリアルからハードマテリアルまで、多種多様な試料の分析に対応。
- サブミクロンからミクロンレベルの3D構造観察、定量解析が可能(FIB断面加工と断面SEM観察の反復により連続断面SEM像を取得し、3D再構成を行う〔図〕。
測定対象試料とサイズ
- -130℃以上、高真空下において固体として存在する試料(Ga+イオン、電子線照射時に変形・変質するものは分析に向きません。)
- 直径150mm×厚さ20mm(観察体積は最大20×20×20µm3程度)
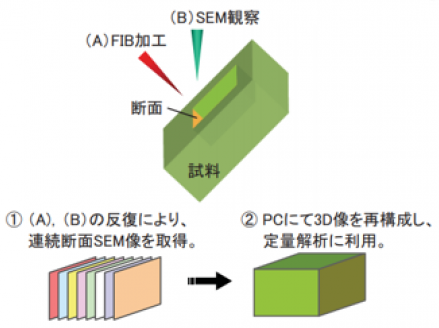
分析事例一覧
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
