TEMでは分析困難な局所異物が評価できます
高い空間分解能(約10 nmφ)を有するFE-AES(Field Emission Auger Electron Spectroscopy)とサブmmの精度で特定の領域を切り出せるFIB (Focused Ion Beam)加工装置を組み合わせることにより、断面方向の局所分析が実現できます。TEMでは、サンプリングで試料を薄膜化する必要があるため、異物が消失する可能性が高いです。しかし、FE-AESでは薄膜化が不要であり、異物を保持したまま測定が可能です。ここでは多層メッキ膜をFIBで断面調製した後、メッキ内部に存在する微小欠陥部位をFE-AES分析した事例を紹介します。
腐食した多層メッキ膜の断面分析
下記に多層メッキ膜の(a)正常部位と(b)欠陥部位の断面SEM写真を示します。表面側からAuメッキ/Niメッキ/Cuメッキの連続膜において、 (b)欠陥部位ではメッキの途切れた箇所に異物と空隙が存在していることがわかります。また、元素分析で特異的元素としてSが検出されたため、その分布状態を元素マッピング測定で調べたところ、異物にはSとCuが同一の分布を示すことが明らかとなりました。これは不純物であるSがCuと反応したことで硫化銅あるいは硫酸銅が生成していることを示唆しています。一方、(a)正常部位で腐食は認められず、目的通りに成膜できていることがわかります。
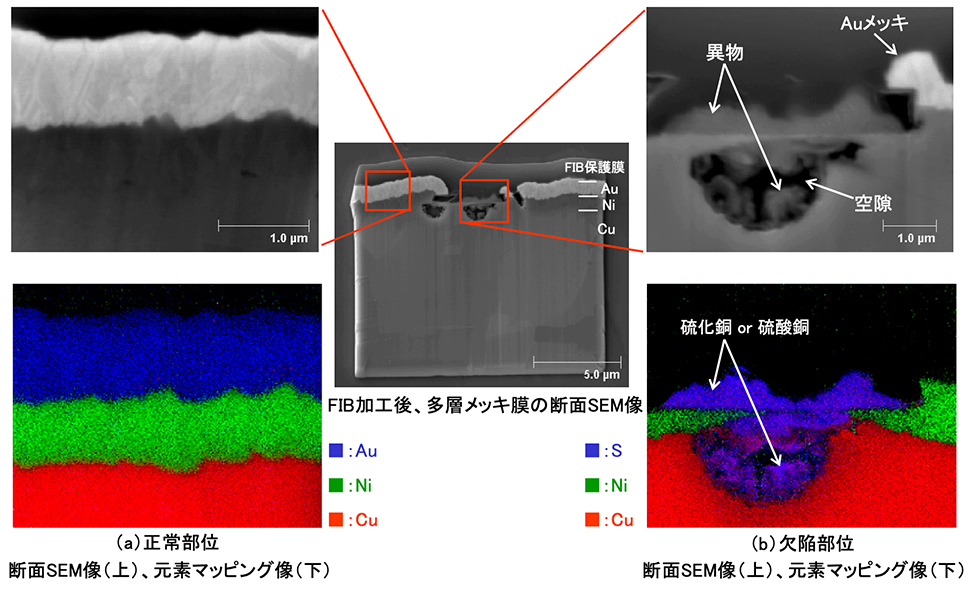
その他の応用
- 記録媒体(磁気テープ)中の磁性微粒子の分析
- 半田メッキ接合部の合金層評価
- ハイブリットポリマー中の金属ナノ粒子の元素分析 など
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
