サブミクロン領域がピンポイントでサンプリングできます
工業製品は異物による製品不良が認められることがあり、製品の歩留まりに大きな影響を及ぼします。この為、異物の特定は非常に重要な分析となります。従来は、数10μmサイズの異物であれば研磨法やミクロトーム法を用いての断面作製・分析が可能でしたが、微小な異物分析は困難でした。今回、FIB(Focused Ion Beam)を導入したことにより、微小異物が分析可能となりました。ここでは、サブミクロンサイズの微小異物について断面試料調製ができた事例を紹介します。
フィルム表面隆起部分の分析
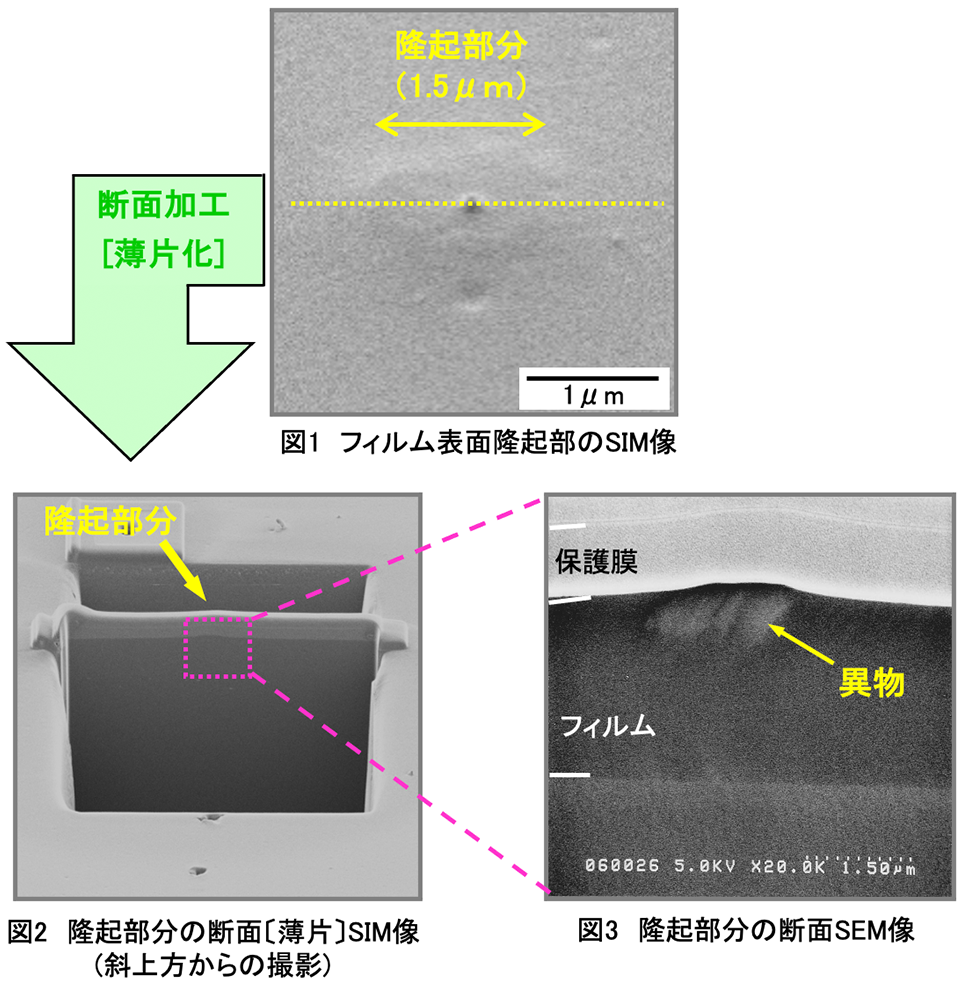
フィルム表面の1.5μmサイズの隆起部分があり、その中央部分サブミクロンオーダーの突起が認められています〔図1〕。隆起の原因を調べるため、突起の中央付近〔図1の破線〕を通るようにFIBによる断面加工[薄片化]を行い〔図2〕、SEMにて観察を行いました。隆起部分の直下に幅2μm、高さ0.5μmの異物が認められ、この異物が隆起の原因である事が判りました〔図3〕。
その他の応用
FIB加工後は観察だけでなく、薄片をピックアップする事により、AESやFT-IRなどの分析に応用展開が可能です。
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
