微量残渣の元素と化学構造がわかります
最近の電子デバイスの製造工程では、微細化、清浄化がますます進んでいます。その傾向にともない、各種製品の品質評価においても材料表面や微小部の成分分析が必須といえます。飛行時間型2次イオン質量分析装置(TOF-SIMS)を用いることにより、固体試料の最表面(深さ1nm以下)や微小領域(大きさ数μm以上)に存在する残渣成分の化学構造を調べることができます。
DC/Tからの粘着剤転写成分の分析
半導体工程において、BG/TやDC/Tを剥離した後、デバイス表面に残留する粘着剤成分はデバイスの品質に重大な影響を及ぼします。ウエハ表面に残存する粘着剤成分は極めて微量であり、FT-IRやESCAなどでは分析することができません。このような場合、極表面の微量成分を検出できるTOF-SIMS分析が有効です。図1にDC/T剥離後のSiウェハをTOF-SIMSで分析した結果を示します。テープ剥離後のウエハからはグリコール成分、ポリジメチルシロキサンが検出され、粘着剤中のオリゴマー成分やセパレーターの剥離剤成分がSiウエハに移行していることが判りました。このように、粘着テープからの極微量の汚染をTOF-SIMSで評価して粘着剤設計に活かすことにより、低汚染性の粘着テープの開発につなげることができます。

回路パターンのレジスト残渣の分析
フォトレジストを用いた微細加工において、現像後のレジスト残渣は後工程での品質に大きな影響を及ぼしますが、回路パターンは複雑かつ微細であり分析は困難です。そこで、TOF-SIMSを用いて、回路パターン〔図2,3〕のレジスト残渣を調べました。レジスト現像部の正2次イオン質量スペクトル〔図4〕には配線に由来するCu+以外にレジストの存在を示すスペクトルパターンが確認され、レジストが完全に除去されていないことが明らかとなりました。また、現像液由来のNa+も検出されています。
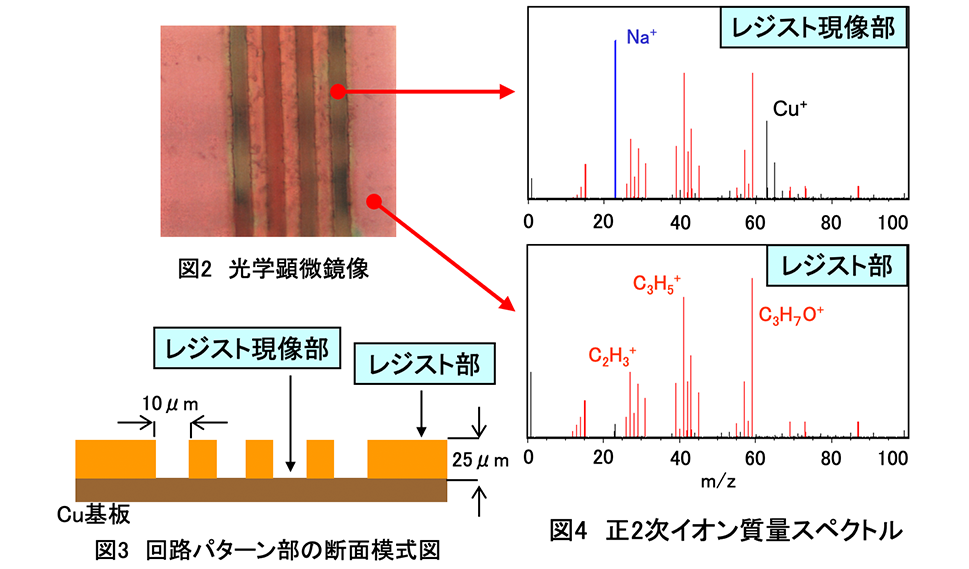
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
