非常に薄い表面付着物の組成がわかります
最表面の元素組成や化学構造を調べるための代表的な分析手法として、X線光電子分光法(ESCA:Electron Spectroscopy for Chemical Analysis)や飛行時間型二次イオン質量分析法(TOF-SIMS:Time of Flight Secondary Ion Mass Spectrometry)などが用いられます。それぞれの装置には特徴があり、例えば、ESCAは元素・化学状態の解析や定量分析に、TOF-SIMSは試料最表面における、有機物の定性分析に用いられます。ここでは、両装置を用いて配線基板の表面付着物について分析した事例を紹介します。
配線基板変色の要因分析
LCDプリント基板のAuメッキ表面に生じる変色部は、外観不良や導通不良,接合不良の原因になっていました。変色の原因の一つとして、非常に薄く付着した有機汚染物があります。この汚染物の組成をESCAとTOF-SIMSを用いて分析を行いました。
ESCA分析
光学顕微鏡像で確認されたAuメッキ変色部と周辺の正常部についてESCA分析を行った結果、変色部では正常部よりもCの元素比率が高く、C-C結合主体の有機物が多く付着していることが明らかとなり、これが変色の原因であることがわかりました。
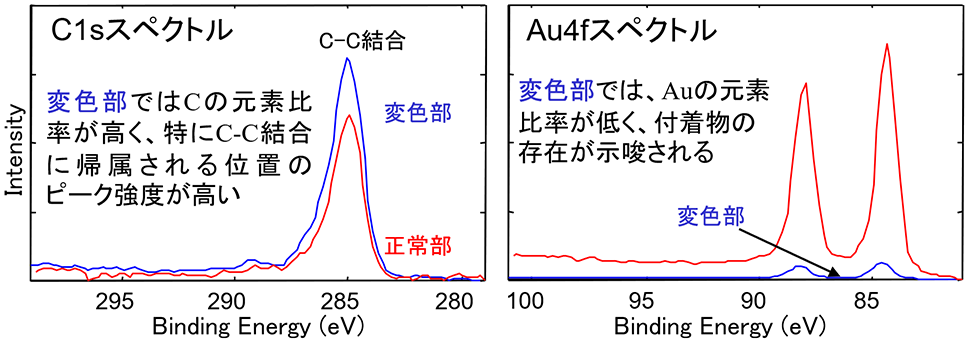
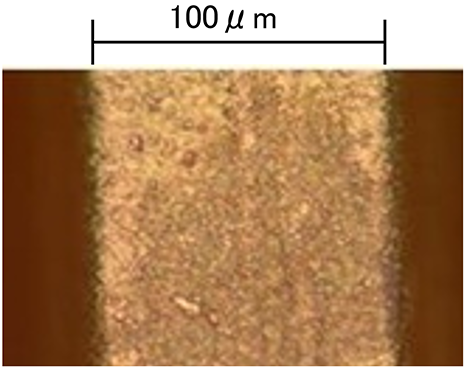

TOF-SIMS分析
TOF-SIMS分析の結果、変色部からESCAの結果に対応する成分として、フェノール系やリン系の酸化防止剤が強く検出され、変色の原因となっている主な有機物を特定することができました。
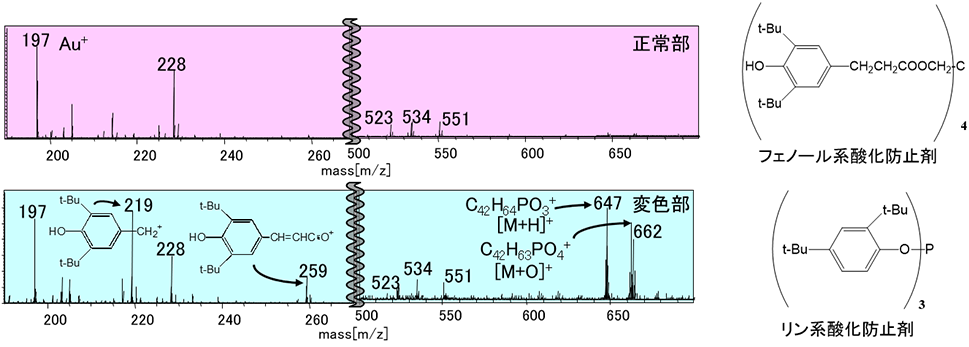
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
