イメージどおりに元素マッピングできます
電子・半導体部品等の工業製品では、形態観察と元素分析を組み合わせた評価が必要不可欠です。工業製品の複雑な形状を表面から元素分析を行うには、 EDXの直上法(フラットEDX)が有効です。
当社WEBサイト EDXの解説はこちら
フラットEDX
通常のEDXは、試料に対して斜め位置で測定を行います。立体的な試料の場合、斜め挿入EDXでは、特性X線を検出できない領域(検出器から見て陰となる部分)が生じます〔図1左〕。一方で、フラットEDXは試料の直上でダイレクトに測定します〔図1右〕。

球状シリカ粒子の元素マッピング
粘着テープ上に分散させた球状シリカ粒子(約45μm径)の元素マッピングを行った事例です。斜め挿入法では、図2の黄矢印で示す箇所のように、検出器から見て試料の陰となる部分では特性X線を検出できず、走査電子顕微鏡(SEM)イメージとは異なる歪なマッピング像となります。一方で、直上法では上記のような影響が少なく、SEMの観察領域を網羅したマッピング像を得ることができます。
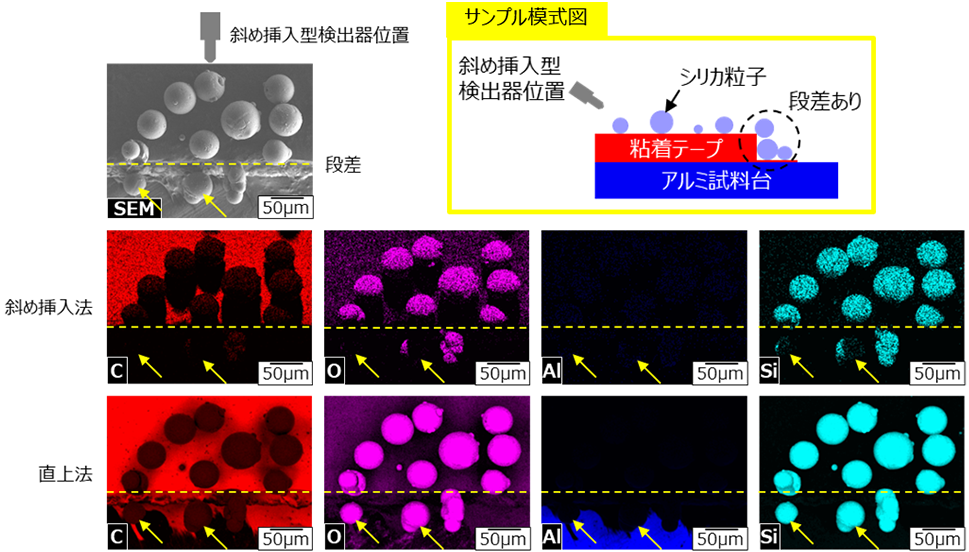
その他の応用
- 基板のスルーホール内部
- 凹凸の大きい試料
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
