ナノ~ミクロンオーダーの仕事関数分布がわかります
仕事関数は金属間接合、トランジスタなどの電子デバイスやOLEDなどの発光素子の性能を決定する重要なパラメータです。近年の走査型プローブ顕微鏡技術の発達により、従来困難であった局所・微小領域の仕事関数の評価が可能となっています。ここでは、ケルビン法を応用した走査型ケルビンフォース顕微鏡(KFM)の事例を紹介します。KFMは金属コート探針(標準金属:仕事関数既知)と試料との接触電位差により仕事関数を求めることが可能です。また、仕事関数は表面状態に強く依存するため、表面の吸着水の影響や、有機汚染を防ぐ目的で真空下での測定が有効です。
In/Cu基板のKFM測定
試料はCu基板上に溶融したIn薄膜を機械研磨法にて整面したものです。形状像〔図1〕から、機械研磨による傷が認められるものの、Inの存在場所はわかりませんでした。それに対して、KFM像〔図2〕からは、暗い領域と明るい領域が確認されました。暗い領域は仕事関数が大きい、明るい領域は仕事関数が小さいことを示しており、前者はCu、後者はInと判断されました。図3の重ね合わせ像から、Inの分布は形状にほとんど依存していないこともわかりました。また、図4にKFM像から求めたエネルギーレベル図と文献値との比較を示します。文献値と測定値で、比較的良い一致が認められました。

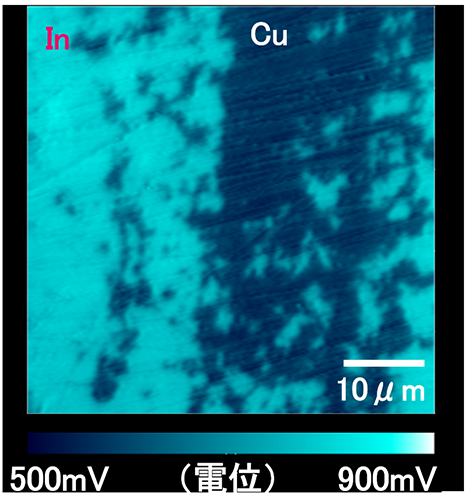

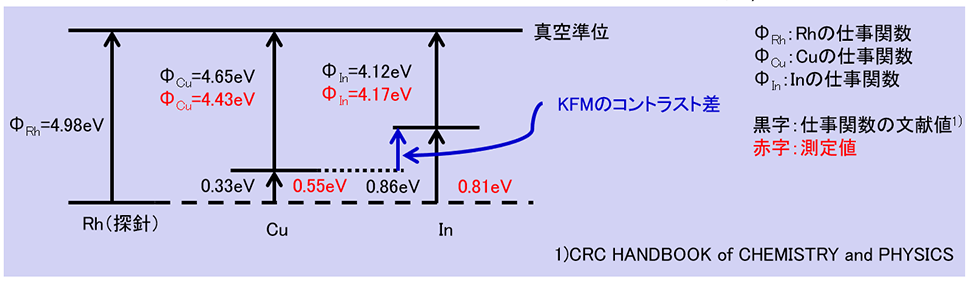
その他の応用
- 各種デバイスの局所電気物性評価
- 金属接合部の評価
