埋もれた微小異物の組成がわかります
デバイス等の製造工程において、微量・微小な異物の混入が製品不良の原因となります。このような異物の化学組成を調べる上で、飛行時間型二次イオン質量分析法(TOF-SIMS)は有効な手法ですが、その分析深さは非常に浅い(約1nm)ため、異物の表面が別の成分で汚染されている場合は、汚染物の情報のみが得られ、異物の化学組成情報は得られません。
このような試料に対して、アルゴンガスクラスターイオンビーム(Ar-GCIB)を用いて表面をスパッタクリーニングし、表面汚染物を除去した後にTOF-SIMS測定を行うことにより、目的異物の化学組成を分析することが可能となりました。
オイルで覆われた微小異物の組成分析
ガラス基板表面に見つかった、オイル状物に覆われた微小異物(粒径約3μm)〔図1〕について、Ar-GCIBによるスパッタクリーニングとTOF-SIMS分析を併用して、その組成を調べました。スパッタクリーニング前の表面TOF-SIMS分析の結果から、オイル状物はシリコーン(ポリジメチルシロキサン)であることがわかりましたが、異物部に対応する箇所からは特徴的な二次イオンは検出されていません〔図2上〕。
そこで、Ar-GCIBを用いてスパッタクリーニングした後にTOF-SIMS分析を行ったところ、下地のガラスが露出しており、異物表面を覆っていたシリコーン成分が除去されたことが確認されました。その結果、異物にはポリフェニレンスルフィド(PPS)が含まれていることが判明しました〔図2下〕。なお、スパッタクリーニングのイメージを図3に示しました。このように、今まで分析が困難であった表面が汚染された微小異物の化学組成を明らかにすることができます。
異物はオイルで覆われています。
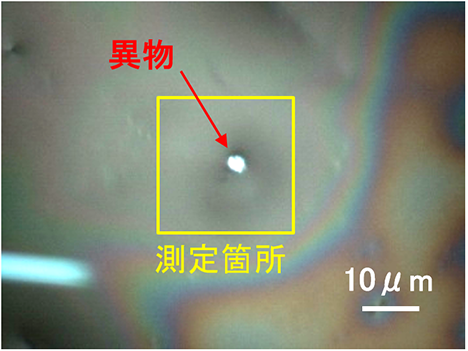
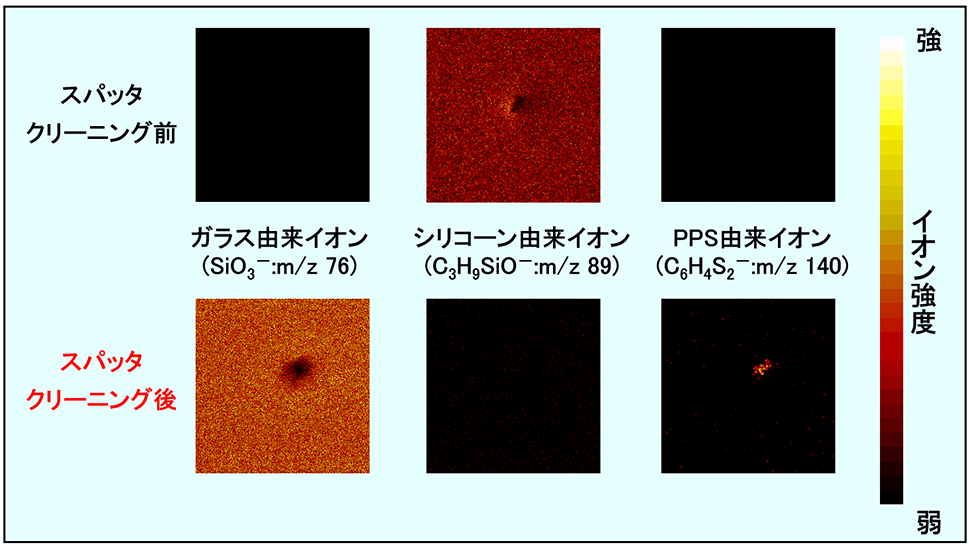

その他の応用
- 局所的な外観異常部(変色部、はじき部等)の分析
- 異種有機材料の界面近傍における組成分布評価(接着不良の原因分析など)
お問い合わせ・ご相談
- 大阪:072-623-3381
- 中部:0532-41-7249
- 東京:03-6632-2066
受付時間:9:00~17:30(土・日・祝祭日・年末年始・夏季休暇・弊社休業日を除く)
高分子分析、形態観察、表面分析、組成分析など、評価・分析に関するご質問・ご依頼はお気軽にお問い合わせください。
