メッキ中の機能性付与元素の分布を高感度で評価できます
メッキは電子部品の高性能化と信頼性確保に不可欠なキーテクノロジーです。そのため、機能性付与、耐腐食性、装飾性の向上を目的としてさまざまな元素が使用されており、これらの元素の正確な分析は製品品質の確保と新技術開発に重要です。メッキの分析として、従来は ICP-MS、SEM-EDX、TOF-SIMS などの手法を用いてきましたが、今回、当社では新たに ソリッドネブライザーICP-MS を追加しました。この革新的な評価技術により、従来困難だった「特定部位における高感度かつ定量的な評価」が可能となります。
今回、SIMカードのメッキ部について、機能性付与元素に着目した深さ方向分析および表面マッピング分析をソリッドネブライザーICP-MSを用いて評価した事例を紹介します。
SIMカードのメッキ部分の深さ方向分析と元素マッピング分析
一般的に、リン(P)はメッキの耐摩耗性・耐食性向上、銀(Ag)は接点の導電性向上を目的として使用されるため、今回の分析では、これらの機能性付与元素がどのように分布しているかを評価しました。
メッキ表面から内部への深さ方向分析の結果、メッキ部は Auメッキ/Niメッキ/Cu合金 で構成されており、機能性付与元素のリン(P)はメッキ表層に%オーダー、銀(Ag)は最表面およびNiメッキとCu合金の界面にppmオーダーで存在することがわかりました。次にメッキ表面のマッピング分析を行った結果、PとAgはメッキ部にほぼ均一に含有されていることがわかりました。
このように、機能性付与元素の分布と濃度の把握は、製品開発における材料選定や製品特性の把握、品質トラブルの原因究明への貢献が期待されます。
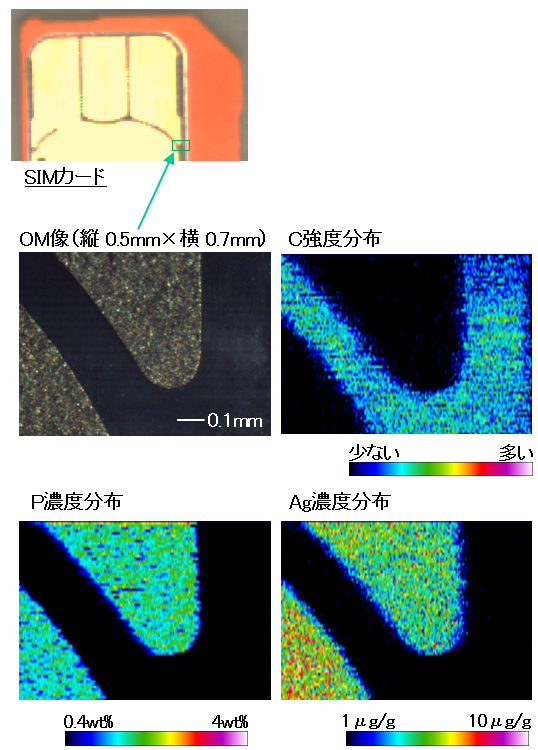
(OM像、C強度マッピング像、P濃度マッピング像、Ag濃度マッピング像)
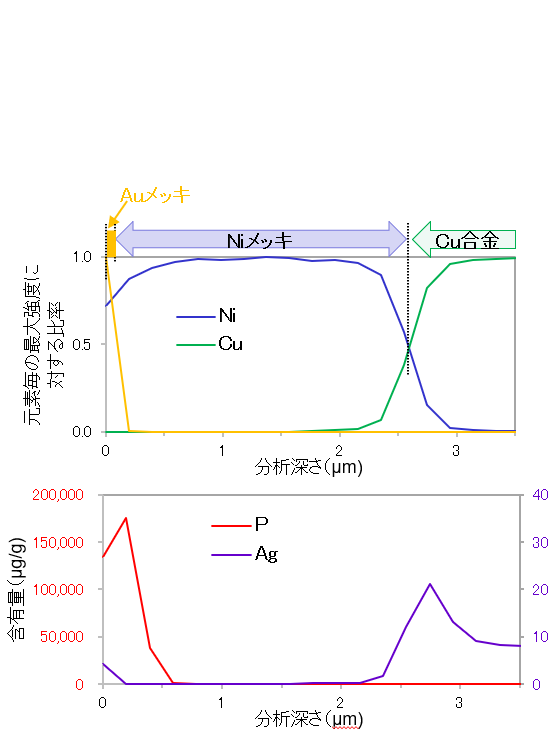
(上段:Au,Ni,Cuの主構成元素、 下段:P,Agの機能性元素)
その他の応用
- メッキ部の不純物元素の定性および定量評価、メッキ表面から内部への硫化の進行度合いの評価
- 樹脂、ガラス、金属の深さ方向および平面方向での元素分布評価
